本文來自:半導體行業觀察
從開發到大批量製造成功過渡到新的製造工藝需要工藝工程師、設備製造商,尤其是化學品供應商之間的集體協作。特別重要的是光刻膠材料的化學性質以及它們與代表每個掩模層圖案數據的曝光光子/電子的相互作用。
未來工藝節點向高數值孔徑(“high NA”)光刻的過渡不僅需要來自系統供應商(例如 ASML)的巨大工程創新,還需要對合適的光刻膠材料進行高級開發。
在最近的 VLSI 2021 研討會上,來自英特爾組件研究小組的 James Blackwell 對即將到來High NA EUV 過渡的潛在光刻膠的選擇和優化提供了極具洞察力的見解。
從他的演講中可以清楚地看出,尋找合適的光刻膠仍然是一個非常活躍的研究領域,必須與系統開發同時進行(使用 EUV 源而不是完整的掃描儀系統)。本文總結了演講的亮點,特別關注了使High NA EUV 實現大批量製造所面臨的挑戰。
背景
在過去十年中,我們行業的一個分水嶺時刻是引入了多圖案光刻(multipatterning lithography),以實現關鍵層上設計間距的持續縮放。爲了在繼續使用 193nm 波長的浸漬曝光 (193i)的前提下實現小於 ~80nm 的間距,我們有必要將掩模數據劃分爲不同的子集。Shapes用子集名稱“colored”——例如雙圖案光刻的“A”和“B”掩模數據。工藝設計套件佈局規則得到擴展,以反映對用於對全層數據進行子集化的算法支持。設計規則驗證功能已擴展爲執行“循環”檢查,以確認將數據分解爲可解析形狀的數據會在掩模庫中成功。例如,循環分解錯誤如下所示。
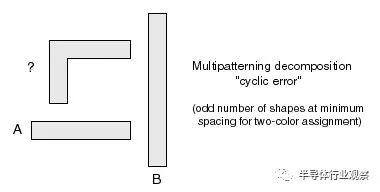
全層圖案化(full layer patterning)是通過針對每個掩模子集的一系列“光刻”步驟實現的——例如,LE-2、LE-3 和 LE-4 分別指定了雙重、三重和四重圖案化的工藝流程。
此外,每個多圖案層的掩模到掩模重疊容差(mask-to-mask overlay tolerance)引入了新的工藝變化來源。同一金屬層上相鄰導線之間的距離以及它們的耦合電容隨 LE-LE 工藝窗口而變化。
多重圖案的演變也導致製造成本增加;以摩爾定律爲指導的“每晶體管成本降低”趨勢減弱。如上所述,隨着在連續工藝節點中繼續採用多重圖案模式,LE-2 演變爲 LE-3 和 LE-4,進一步導致更高的成本,如下所示。
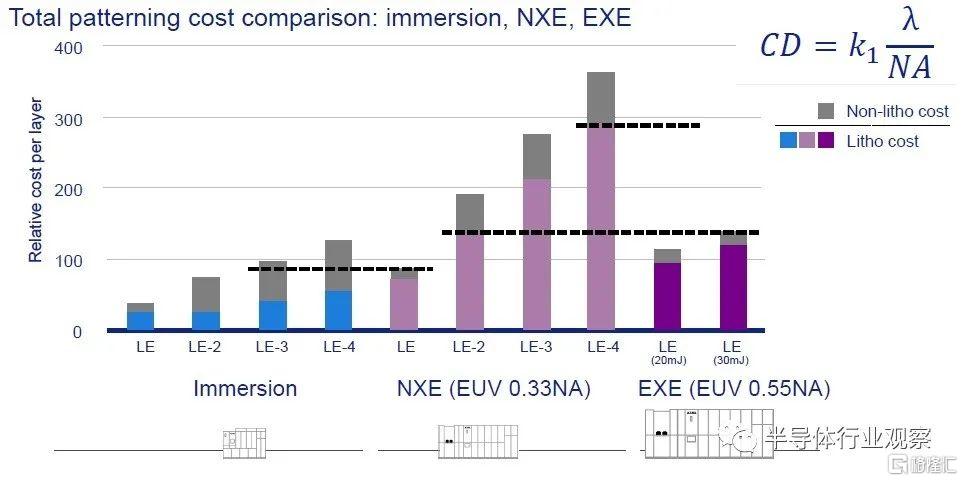
(1)極紫外光
經常閱讀 SemiWiki 的讀者無疑熟悉波長爲 13.5nm 的極紫外 (EUV) 光刻系統的最新發展,以取代 193i 光刻。爲了應對多圖案成本上升的趨勢,EUV 系統在曝光吞吐量(每小時晶圓數)、曝光強度和系統正常運行時間方面已達到生產狀態。如上圖所示,業界正在積極開展研發工作,以發佈第二代 EUV 系統。該系統將在透鏡路徑中加入更高的數值孔徑 (NA = 0.55),從而實現更精細的間距分辨率,並再次重新校準 EUV 多重圖案化與第一代 NA=0.33 設備的每層成本趨勢。
可以肯定的是,EUV 系統是一個工程奇蹟。然而,EUV 光刻演化的一個經常被低估的方面是相應光刻膠材料的相應開發工作。
(2)光刻膠基礎知識
簡而言之,將塗有光刻膠的硅片選擇性地暴露於高能光子(或高能電子)會導致原始材料的化學鍵構型發生變化。對於(正性)有機光刻膠聚合物(organic photoresist polymer),入射光子會導致“脫保護”(deprotection)化學反應;隨後的步驟是將曝光的硅片浸入顯影劑中,從而溶解脫保護的聚合物。雖然每個新工藝節點的尺寸目標更加嚴格,但基本目標並沒有真正改變:
對光子波長/能量的高吸光度和選擇性 (E=h*f):目標是更低的光子劑量 (mJ/cm**2) 和更大的曝光寬容度
高對比度
化學反應的低散射:對化學構型差異的高顯影劑選擇性,目標是減少顯影圖像的“線邊緣粗糙度”(line edge roughness“LER)
低粘度:易於光刻膠應用;因爲需要一層薄而均勻的 PR 層(在旋塗和預烘烤之後),因爲 EUV 曝光的焦深(depth-of-focus )非常小。
對晶圓基板表面的良好附着力
蝕刻步驟後易於去除光刻膠
對於最近的工藝節點,已經引入了化學放大抗蝕劑 (chemically-amplified resist :CAR) 材料。CAR 組合物在抗蝕劑中引入了“光酸產生劑”(photoacid generator:PAG)。簡單來說,光酸(photoacid)是一種在吸收光時釋放質子 (H+) 的分子,稱爲光解離(photodissociation)。曝光後,隨後的加熱步驟會釋放出酸,該酸充當聚合物裂解的催化劑。
酸在脫保護過程中不會被消耗,而是繼續通過抗蝕劑擴散以提供(數百個)反應,從而放大光子能量劑量的影響。抑制劑或猝滅劑(nhibitor or quencher)化合物也被結合到 CAR 中,連接到抗蝕劑聚合物鏈。這種酸溶性抑制劑減輕了酸擴散並改善了溶解對比度,從而減少了產生的 LER。
與 EUV 光刻的低焦深相關的薄光刻膠膜厚度,結合減少劑量以提高系統吞吐量/正常運行時間的目標,意味着 EUV 曝光是一個隨機過程,事件中的(隨機)變化光子/單位面積密度。
聚合物-CAG-抑制劑組分密度的不均勻性是另一個變化來源。過渡到薄有機光刻膠薄膜的另一個困難折衷是需要對圖案化後蝕刻(或注入implant)工藝步驟足夠堅固。較厚的 PR 層對後續步驟更堅固,但在較低的曝光劑量下更難解決。如下圖所示,高縱橫比顯影的 PR 薄膜會出現“圖案塌陷”(pattern collapse)。

顯影液的表面張力會破壞相鄰的高 PR 線之間的間距。
因此,工藝工程師專注於改進 EUV 計量,以發現光刻缺陷機制——例如,未完全開發的線路和通孔。EUV 演進中強烈相互依賴性的另一個跡象是半導體設備供應商專注於快速、在線光刻檢測。
抗High NA EUV(Resists for High NA EUV)
James 提供的數據是英特爾、光刻膠供應商、學術機構和研究實驗室密切合作的結果。下圖說明瞭由High NA EUV 實現的光刻間距的目標轉變,以及需要更薄的抗蝕劑塗層以減少焦深。

在高數值孔徑 EUV 系統可用之前,材料工程師如何評估潛在的光刻膠材料?James 描述了英特爾專門爲光刻膠研究開發的系統,如下圖所示。
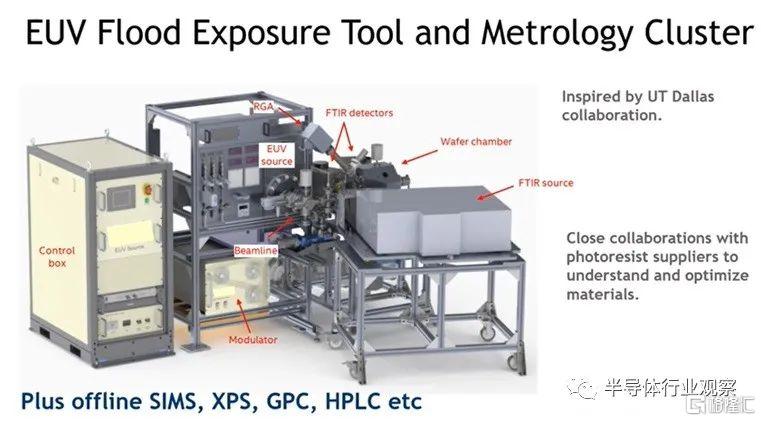
EUV 源連接到wafer chamber。James 重點介紹了添加到系統中的傅立葉變換紅外光譜 (FTIR) 檢測功能。(FTIR 使用材料在紅外光譜曝光中的吸收來提供材料分析;它可以提供有關反應物和化學反應產物濃度的實時數據。)該系統使英特爾能夠深入瞭解光刻膠對 EUV 曝光的響應。
EUV 光刻膠研發的一個獨特方面是使用金屬氧化物抗蝕劑化學作爲傳統聚合物材料的替代品的潛力。這些“無機”抗蝕劑具有高 EUV 吸收率和高抗蝕刻性,可用於後續加工。下圖提供了金屬氧化物與有機抗蝕劑化學的簡化比較。

James 描述了使用 Hf-OC 的金屬氧化物抗蝕劑的一種選擇。(行業中也正在積極研究 Ti 和 Zr 的氧化物。)抗蝕劑的化學反應順序如下所示 - FTIR 分析證實反應過程中存在 CO2,Hf-OC 簇的交聯爲結果。
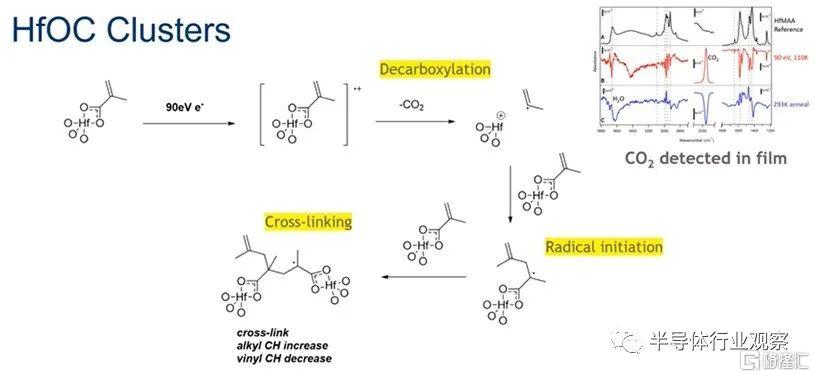
請注意,曝光後的cross-linking 不同於前面描述的光解(photodissociation),其中溶解度“開關”(switch)現在與負抗蝕劑相關。
James 還描述了使用有機 CAR 抗蝕劑進行 EUV 曝光的結果。建議的抗蝕劑(加 PAG 加抑制劑)化學的一個例子,以及相應的對比與劑量曲線如下所示。

如前所述,抗蝕劑組合物的不均勻性導致顯影圖像的變化增加。James 描述了英特爾團隊爲評估抗蝕劑的均勻性而進行的實驗,如下圖所示。
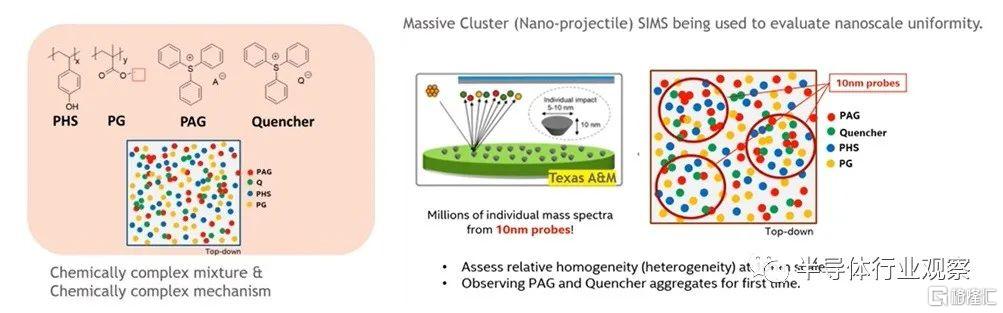
在這種情況下,二次離子質譜 (secondary ion mass spectroscopy:SIMS) 用於分析聚焦入射離子束大小的薄膜成分,並聚集大量樣品以評估 PR 異質性。
用 James 的話來說,“這種 SIMS 方法提供了數據來指導我們進行化學變化,從而提高圖案均勻性。需要更好的分析方法來改進 EUV 抗蝕劑設計,以應對High NA EUV 帶來的挑戰——例如用於金屬氧化物抗蝕劑的 SIMS 和 FTIR。而且,與供應商的密切合作至關重要。”
總結
高數值孔徑 EUV 系統的引入將是解決與 EUV 多重圖案相關的成本問題的關鍵步驟。然而,正如英特爾在 2021 年 VLSI 研討會上的演講所表明的那樣,爲了滿足相應的光刻膠材料要求,特別是解決有機材料與金屬氧化物材料之間的權衡問題,顯然還有大量的開發(和資格認證)。看看並行且相互依存的光刻系統和光刻膠技術如何發展將會非常有趣。
附:high NAEUV光刻機介紹